Please select your location and preferred language where available.
近年急速に進化するコンピュータや人工知能(AI)には、情報を記録するための高性能メモリの開発が欠かせません。私たちは、低消費電力かつ大容量を両立させた新たなメモリ技術、Oxide-Semiconductor Channel Transistor DRAM (OCTRAM) の開発に取り組んでいます[1]。この技術の実用化にあたっては、メモリへの書き込みと読み出しを担うトランジスタの信頼性が極めて重要です。
OCTRAMでは、酸化物半導体(InGaZnO)を用いた縦型ゲートオールアラウンド構造のトランジスタを採用することにより、低消費電力を実現しています(図1)。一方で、大容量化を目指して微細化を進めていく上で、トランジスタが故障に至るまでの寿命が短くなる課題が明らかとなりました。そこで私たちは、トランジスタの故障現象のうち経時絶縁破壊(Time dependent dielectric breakdown, TDDB)に注目して徹底的に調査を進めました。その結果、トランジスタの微細化による内因的な寿命の劣化に加えて、トランジスタ形状やプロセスダメージに起因する外因的な劣化があることがわかりました。外因性の劣化を改善するためにプロセス改善を進めたところ、新しいプロセスを適用したトランジスタの寿命予測は10年以上に達しました(図2)。これは、信頼性の高いデバイスを作製できることを意味しています。この技術により、低消費電力かつ大容量化を実現する新しいメモリの実用化が期待されます。
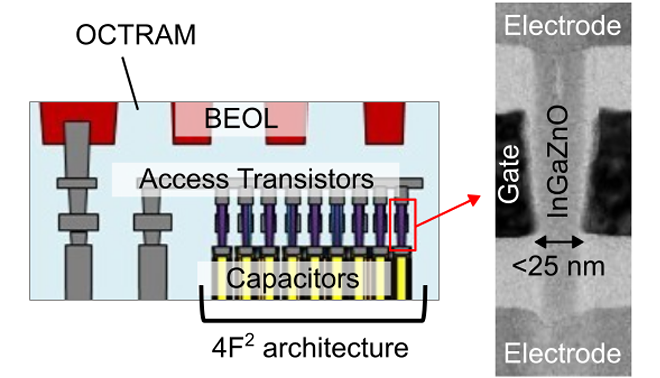
Copyright (2025) The Japan Society of Applied Physics

Copyright (2025) The Japan Society of Applied Physics
本成果は2025年6月に京都にて開催された国際学会IEEE Symposium on VLSI Technology and Circuits 2025において発表されました。
文献
[1]キオクシア株式会社. 酸化物半導体を用いた新しいDRAM(OCTRAM)技術の開発を発表. 参照2025年8月25日.
[2] A. Kamiyama et. al., “First Thorough Assessment of Time-Dependent Dielectric Breakdown in Sub-25 nm Gate-All-Around Vertical InGaZnO Transistor for 4F2 DRAM Application”, 2025 IEEE Symposium on VLSI Technology and Circuits, T20-3.

