Please select your location and preferred language where available.
近年の3Dメモリデバイスにおいて、最も加工の難しい構造のアスペクト比は100を超え、今後も高くなる見込みです。そのようなアスペクト比の高い構造を形成するプラズマエッチングプロセスは生産性を大きく左右します*1,2。エッチングプロセスに用いるプラズマ中では、イオン分子と中性ラジカル分子が生成されますが、アスペクト比の高い構造では指向性の高いイオン分子がエッチングにおける重要な役割を担っています(図1(a))。本稿では、シミュレーション技術を活用して、高アスペクト比構造の形成に最適なイオン分子組成を予測した事例を紹介します。
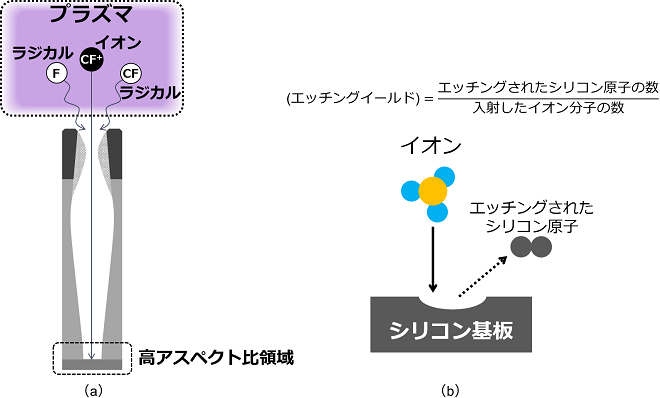
イオン1分子がエッチングするシリコン原子の数を、イオンエッチングイールドと言います(図1(b))。従来、イオンエッチングイールドはイオンビーム実験[1]や分子動力学計算[2]によって算出されてきました。しかし、それらはコストと時間のかかる方法です。また、実際のエッチングプロセスで用いられている比較的大きいイオン分子のデータが不足している、という課題もありました。そこで、イオン分子が基板に入射したときに起こる表面反応をモデル化し、これまで得られなかったイオン分子についてのエッチングイールドを予測できるようにしました。
図2は、イオン分子が引き起こす表面反応をモデル化したものです。基板の表面に炭素とフッ素で形成されるCF膜が堆積したり、その膜や基板がけずれたりする反応が競合しながらエッチングが進行します。私たちのシミュレーションではモンテカルロ法を用いて、この複雑な現象の時間発展形状を計算しています。シミュレーションから得られる定常状態のエッチレートと基板の密度、イオンドーズ量から、前述のエッチングイールドを算出します。この手法では、あるイオン種のエッチングイールドを数十秒で求めることができます。
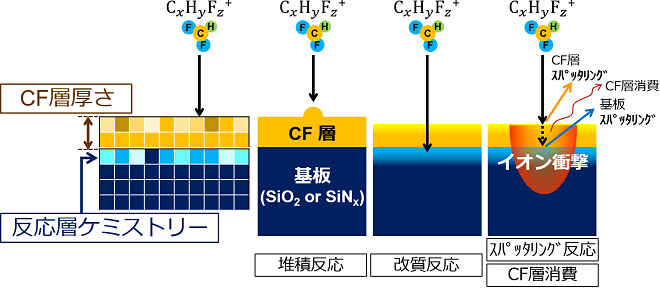
エッチングイールドが短時間で得られるようになったため、イオン分子の組成を変えたときのエッチングイールドを網羅的に調査することが可能となりました。図3はSiO2基板とSiNx基板における各イオン種のエッチングイールドを示しています。これらのシミュレーション結果より、イオン分子の組成を変えたときのエッチングイールドの変化や被エッチング膜のちがいによるエッチングイールドの傾向など、幅広い依存性を把握することが可能となりました。

シミュレーションの活用範囲は、プロセス改善提案にとどまらず、現象の直感的な理解やプロセスエンジニア間でのイメージの共有など、多岐にわたります。今後も、実験とシミュレーションを相補的に活用し、プロセス開発の見通しを立てる取り組みを継続していきます。
本技術は2022年11月に開催されたThe 43rd International Symposium on Dry Process (DPS2022) において報告しました[3]。
記載されている社名・商品名・サービス名などは、それぞれ各社が商標として使用している場合があります。
文献
[1] K. Karahashi, K. Yanai, K. Ishikawa, H. Tsuboi, K. Kurihara, and M. Nakamura, J. Vac. Sci. Technol. A 22, 1166 (2004).
[2] K. Miyake, T. Ito, M. Isobe, K. Karahashi, M. Fukasawa, K. Nagahata, T. Tatsumi, and S. Hamaguchi, Jpn. J. Appl. Phys. 53, 03DD02 (2014).
[3] A. Kawamoto, J. Kataoka, S. Kuboi, T. Sasaki, and N. Tamaoki, Proceedings of 43th Dry Process Symposium (Osaka, 2022), p.14.

