Please select your location and preferred language where available.
UVナノインプリントリソグラフィ(Nanoimprint Lithography、以下NILと表記)は、テンプレートを基板上のレジストに押印し、レジストをUV硬化することによりパターンを転写します。微細なパターンにおいてもぼやけやにじみの影響がなく、忠実度の高いパターニングを実現する有望なプロセスです。特に、複雑な3Dパターン、微細な2D・1Dパターンを、光リソグラフィと比較して、より少ないプロセスステップで形成することができる(図1)ため、コスト削減への効果が期待されています。
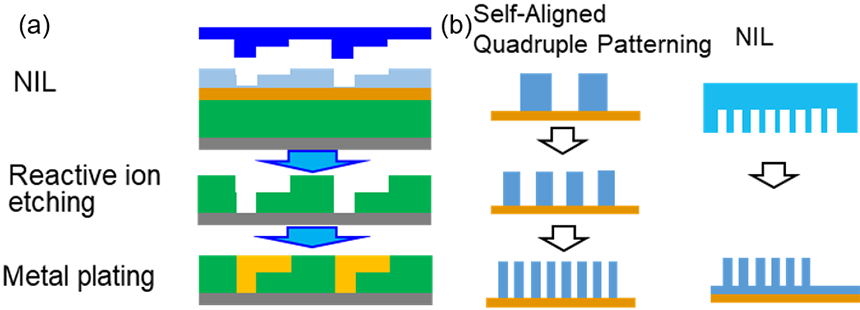
半面、光リソグラフィと比較してプロセス調整手段が限定されるため、NILにカスタマイズされた設計制約を導入してプロセスマージンを拡大します。今回、NILプロセスマージンの問題に対処するために、2種類の設計制約を抽出しました。1つは、低欠陥と信号強度を両立するNILアライメントマークの設計制約です。もう1つは、低欠陥を実現するためのレイアウト被覆率と基板上段差の組み合わせ規約です。私たちは、先端デバイスを模したテストパターンを用いた実験結果を、NILプロセスシミュレーションを用いて補間することにより、様々の条件を想定した設計規約を抽出しました(図2)。
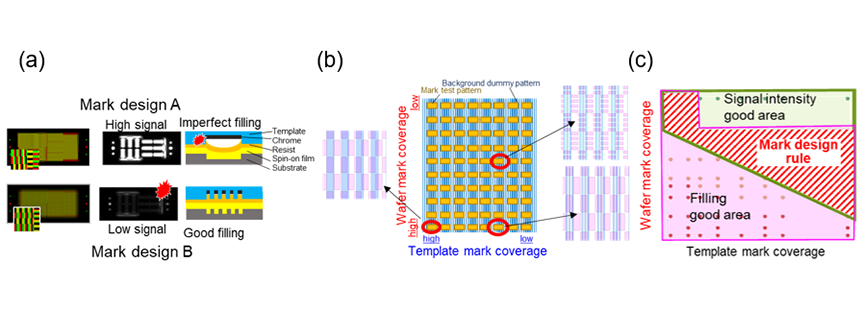
これらの規約を抽出し、考慮する設計フローを使用することにより、歩留まりの問題を低減し、再設計を減らすことで、生産の歩留まりを大幅に向上させることができると考えています。
本技術については、2022年4-5月に開催された国際会議SPIE AL(Society of Photo-Optical Instrumentation Engineers Advanced Lithography) DTCO and Computational Patterningにて発表を行いました。
本稿は、文献[1]から図面等一部抜粋&再構成したものです。
文献
[1] Sachiko Kobayashi, Satoshi Mitsugi, Katsuyoshi Kodera, Kazuya Fukuhara, Anupam Mitra, Koki Ueha, Katsuya Abe, Motofumi Komori, Shingo Kanamitsu, Takuya Kono, “Design process integration enabling the productivity enhancement for nanoimprint lithography”, Proc. SPIE 12052, DTCO and Computational Patterning; 1205208 (2022) © 2022 Society of Photo Optical Instrumentation Engineers (SPIE).

