Please select your location and preferred language where available.
スマートフォンなどの携帯端末には、フラッシュメモリが内蔵された半導体パッケージが数多く搭載されています。半導体パッケージ内にはフラッシュメモリとともに制御するためのコントローラチップも内蔵されています。特にコントローラチップから発生する輻射ノイズが、アンテナを介して高周波回路に影響し、通信距離の劣化やデータ伝送速度の低下を引き起こすことが知られています(電磁干渉)。従来はこのような電磁干渉を防ぐためには、複数の半導体パッケージを覆う金属板(板金シールド)が使用されています。しかし、板金シールドでは、携帯端末の薄型化に対応できない問題がありました。この問題を改善するため、半導体パッケージ自体を金属膜で覆い、シールド効果を持たせる電磁波シールドパッケージを開発しました[1]。図1に電磁波シールドパッケージの写真、図2に電磁波シールドパッケージの断面を示します。
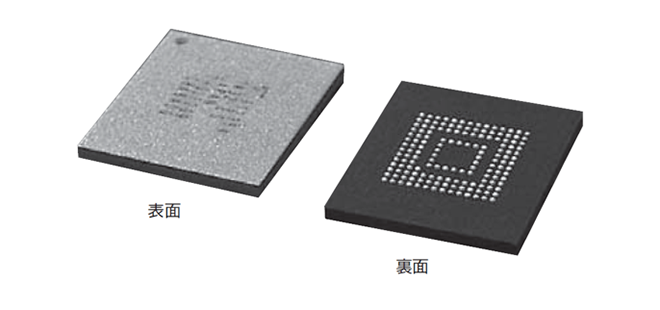
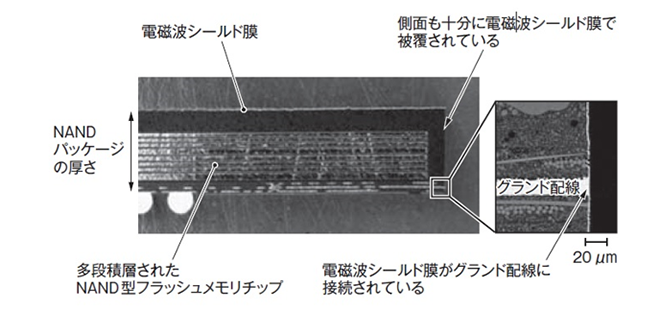
電磁波シールドパッケージでは金属膜を配線基板の銅配線に接続するとともに、フラッシュメモリを封止するモールド樹脂と、後に形成する金属膜との密着性を確保する必要があります。金属膜は主として銅を使用し、半導体製造プロセスの前工程で使用されているスパッタ法で形成しています。
今回、モールド樹脂と銅との密着メカニズムについて検討した結果、密着性を確保するためには、以下の2つが必要であることがわかりました[2]。
- モールド樹脂に含まれる樹脂成分をプラズマエッチングしてシリカ(SiO2)フィラーを露出させる必要があります。図3には横軸にモールド樹脂表面のシリカフィラーの露出量とクロスカット法による剥離率の関係を示します。シリカフィラーの露出が増えるとともに剥離率が減少していることが分かりました。
- モールド樹脂の吸湿分を除去する必要があります。
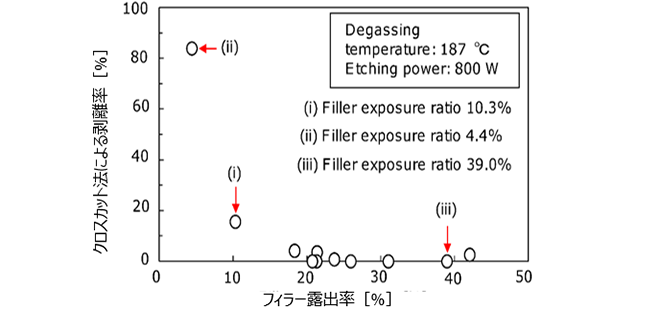
上記をまとめた密着メカニズムを図4に示します。
図4:モールド樹脂と銅との密着メカニズム[2]
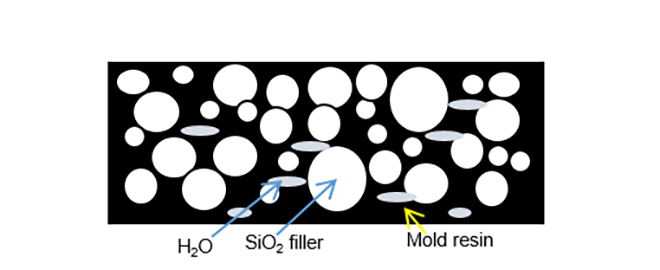

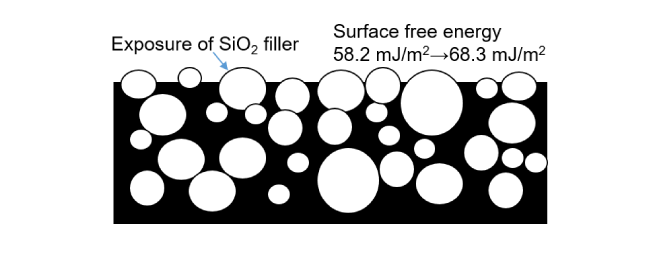
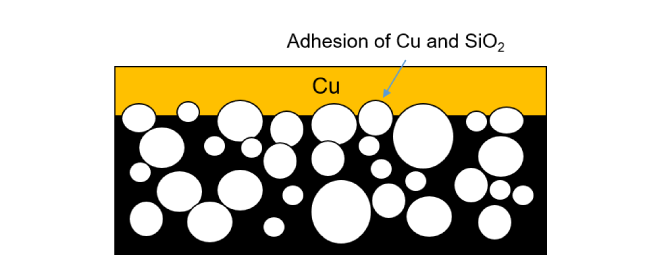
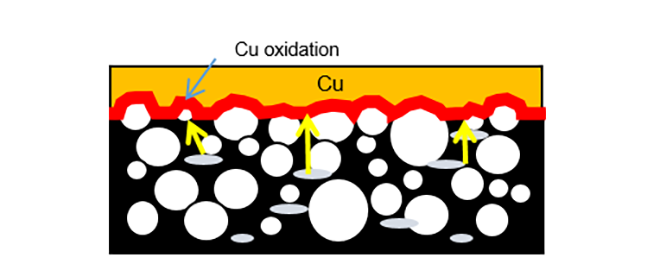
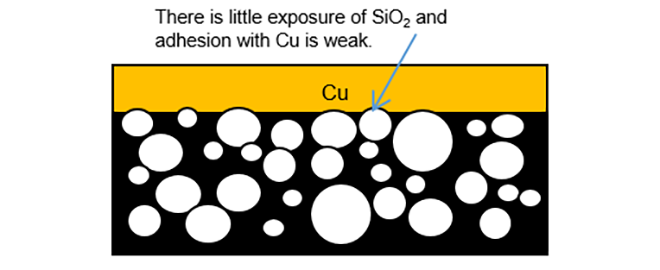
引き続き、異種材料の密着メカニズムの解明および半導体製造プロセスの前工程と後工程(パッケージング)を融合させた高付加価値の高い製品のプロセス開発を進めます。
本稿は、文献[1]@2016 東芝レビュー、[2]@2022 Thin Solid Filmsから図面等を一部抜粋&再構成したものです。
文献
[1] 山崎 尚、高野 勇佑、本間 荘一、「半導体パッケージにおけるスパッタ成膜法を適用した電磁波シールド膜形成技術」、東芝レビュー、2016、71巻、6号、pp. 16-19.
[2] S. Homma, M. Shima, Y. Takano, T. Watanabe, K. Murakami, M. Fukuda, T. Imoto, and H. Nishikawa. “Adhesion mechanism between mold resin and sputtered copper for electromagnetic wave shield packages”, Thin Solid Films, 2022, vol. 750, 139188.

